サイト内の現在位置
電子顕微鏡分析
提供サービス
FIB-TEM分析
FIB-TEMによるナノ構造解析
電子デバイスの製品開発は年々微細化が進み、管理される膜厚や構造はナノの領域に入っています。研究開発や製造工程で発生する様々な問題の解決をお手伝いいたします。
分析事例
応用
- デバイス上の微小異物の発生原因調査
- 多層膜の膜厚確認、膜間介在物の確認
- 金属板上の酸化皮膜の観察、組成分析

使用する機器
- 走査型透過電子顕微鏡(STEM)
日立製作所製HD-2000 - 収束イオンビーム加工観察装置(FIB)
日立製作所 FB-2100
日立製作所 FB-2000A

STEMの概要(Scanning Transmission Electoron Microscope)
走査型透過電子顕微鏡で電子線を細く絞り、その絞った電子線で、FIB等で薄膜に加工した試料を走査、透過した電子や、2次電子から微小領域の組成や構造を観察・分析します。

異物の定性分析事例

数nmの異物・薄膜の定性分析が可能です。
シリコン単結晶/絶縁膜界面のTEM像観察事例

50万倍以上の高倍率で試料観察が可能です。
デバイス断面の観察事例
任意の場所の断面観察が可能。TEM像とSEM像が同時に撮影できます。

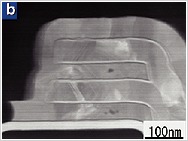
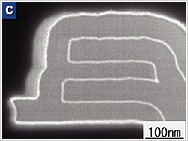
| specimen:DRAM | Acc.Volt.:200kV | Magnification:×200,000 |
デバイス断面のマッピング事例
FIBで狙った位置を切り出し、断面元素のナノスケールの分布を確認することができます。
O-N-O膜部のEDX元素マッピング
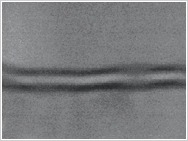



| プローブ径:0.5nm | 集算時間:約5分 |
断面FIB-TEMの低価格サービス
| 基本仕様 | 備考 | |
|---|---|---|
| 試料素材 | FIB加工可能な素材(応談) | ・加工が難しいソフトマテリアルや低融点素材は不可 ・ダイアモンド・SiC等の加工レートが低いものは応談 |
| 加工領域 | ~幅20um×高さ15um | ・左を超える場合も別途応談 |
| 観察視野数 | ~7視野 | ・信号はBF-STEM/HAADF/SEの3種 |
| 最大倍率 | ~500k倍 | ・500kを超える場合も別途応談可 |
| 納期 | 応談 | ・特急対応も応談 |
5試料以上一括(類似解析)にて低価格サービス(当社通常価格の約半額!)承ります。
- 観察は加速電圧200kV(固定)のSTEM装置になります。
- 手法はFIBによるマイクロサンプリング法になります。
- 計測サービスは数量により応談とさせていただきます。
- 元素分析は別途となります。
【観察事例】半導体チップの断面
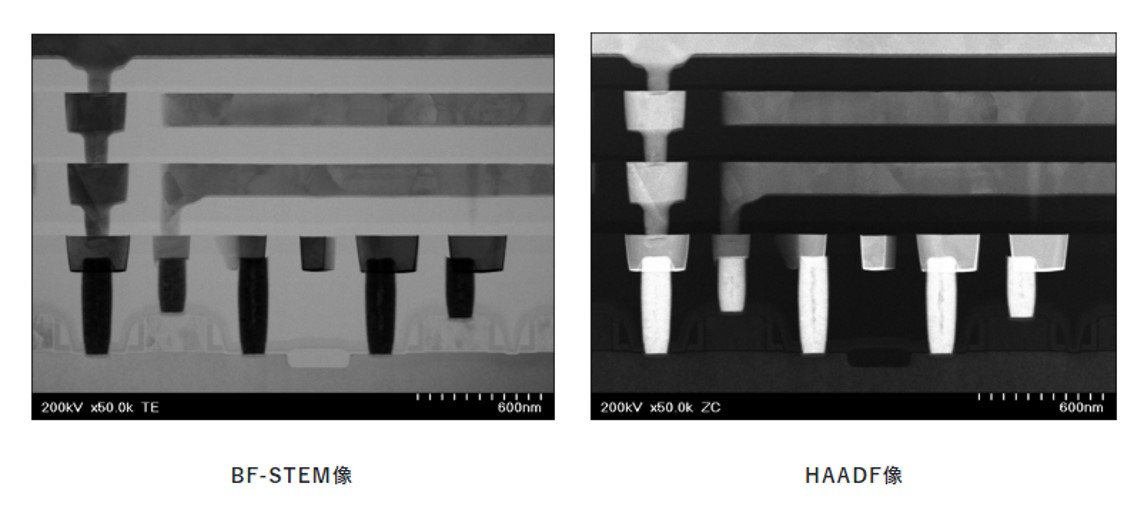
液体TEM分析
ナノ構造解析
電子デバイスの製品開発は年々微細化が進み、管理される膜厚や構造はナノの領域に入っています。当社は最新の装置を駆使し、研究開発や製造工程で発生する様々な問題の解決をお手伝いいたします。


液体TEM観察のご紹介
通常の電子顕微鏡観察では試料を装置の真空内に入れる為試料を乾燥させますが、この場合試料の凝集や破壊が起こり正しい試料の状態が観察ができません。
当社では特殊な手法を用いて、液体のまま試料を観察することが可能となりました。
従来技法(乾燥後の観察)


通常は真空内に入れる為、凝集により粒子のサイズ・分布は不明となります。
本技法(液中観察)
液中観察により、牛乳中のCa粒子の形状・サイズ・分布を正しく観察できました。
観察1
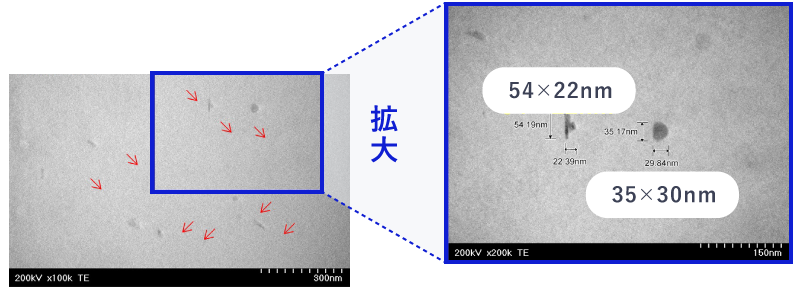
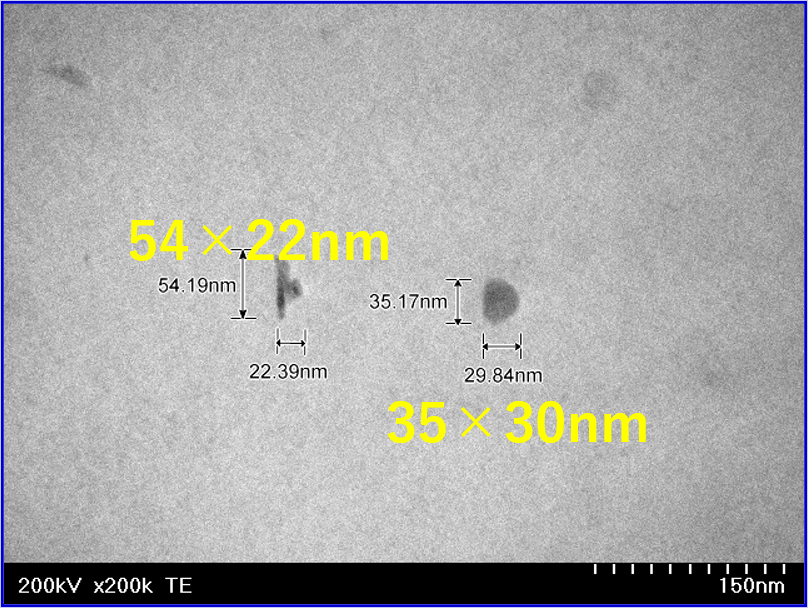
観察2
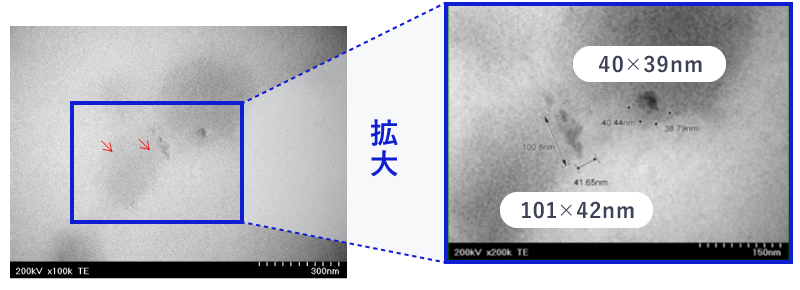

正しい粒子サイズ 、分散状態を把握することで、新商品開発に貢献します。
FE-SEMによるドーパントの可視化
FE-SEMによるドーパント可視化事例
使用装置

断面観察
| CP加工品 | FIB加工品 |
|---|---|
| パワーデバイス(Si) -アクティブ領域- |
SRAM -セル領域- |
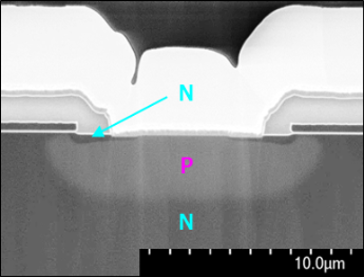 |
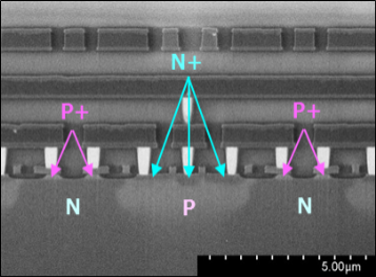 |
| 表面照射型CMOSイメージセンサー -画素領域- |
ツェナーダイオード (Poly-Si) |
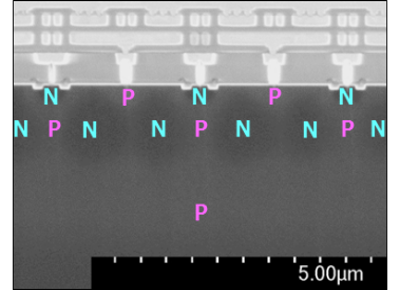 |
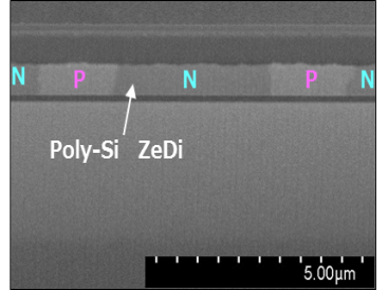 |
- 断面観察はCP/FIB共に対応できます。
- Si~ワイドバンドギャップ材料に対応できます。
キャリア濃度により充分な解像度が得られない可能性もありますので詳細はお問合せ下さい。
ソフトマテリアルの観察事例